Ʒ����ƄӽK���I(l��ng)��������ѓQ���ž���


�����֙C(j��)���^��(chu��ng)���ڱ��У����܄�(chu��ng)�����������Q�C(j��)����
�M���ڽ�(j��ng)��(j��)���еĴ��£������֙C(j��)�ИI(y��)�����°���ѳɶ��֣����ڴ�����Ļ��A(ch��)�ϣ�һ���I(l��ng)�^���O���ȏS���M(j��n)�й��܄�(chu��ng)�£�����ʾ��Ч��(y��ng)�����S�̸��M(j��n)�����M(f��i)���������ӌ��ƄӓQ�C(j��)�ᳱ�������֙C(j��)�Ĵ�����Ј����N(y��n)�ؾ��������K�˾��^�S�̌��߱M���ܸ������M(f��i)��ʹ�c(di��n)�Ķ����l(f��)�Q�C(j��)�����Z�Ј����~����������֙C(j��)�������^ȥPCB��Ҫ�����Α�(y��ng)�ã���PCB�ij��L�(q��)���ھ�Ĵ���߅�������о�����
�v�^�^ȥ������������֙C(j��)�l(f��)չڅ�ݣ�ָ�y�R�e��3D Touch���������p�z�ȳ��m(x��)��(chu��ng)���c(di��n)������ӿ�F(xi��n)��Ҳ����̼��Q�C(j��)������
���֙C(j��)�M(j��n)������r���Ĵ��£�����w�����A(ch��)�Q�����u�c(di��n)��(chu��ng)�����l(f��)���������L��Ȼ����������^����(sh��)���ľ�������������(chu��ng)��ͬ�ӕ�Ӱ�ȫ��PCB��δ���������֙C(j��)��PCB����������(chu��ng)�����������]�F(xi��n)���֙C(j��)�ij�؛Ҏ(gu��)ģ�������֙C(j��)�S�����еĸ��M(j��n)��Ը����(chu��ng)�����������ٝB���Ķ����F(xi��n)����c�ڹ�W(xu��)���W(xu��)���I(l��ng)����F(xi��n)�O����(chu��ng)�����I(l��ng)���ИI(y��)��(y��u)�ݏS�̘I(y��)���Ƀr�R�w��Win-Win��M؞��


�O�����I(l��ng)ȫ��PCB�a(ch��n)�I(y��)��(chu��ng)��څ��
�O����˾���֙C(j��)�����������M(f��i)����ИI(y��)�ļ��g(sh��)���I(l��ng)�ߡ��O��ÿһ�μ��g(sh��)���£������o�a(ch��n)�I(y��)朎����e���p�ص�Ӱ푡��������ι���(y��ng)�̶��ԣ��O�����a(ch��n)�I(y��)朵Ď��������w�F(xi��n)�ڃɷ��棬һ���O���������ӆ�������nj���A�S�̵�ʾ��Ч��(y��ng)��
�۽�PCB�ИI(y��)��FPC������ӻ�(li��n)HDI�ı��l(f��)���������O����(ji��n)����(d��o)�룬���������S�̸��M(j��n)�����c(di��n)ݗ�䵽���γɿ��ٝB�ĵ䷶��



�O����FPC��(ji��n)�����o(h��)�ߣ�����FPCѸ�ٝB���I(l��ng)��ИI(y��)���L��
FPC�ֱ��Q��“ܛ��”�����Ծ��������������Ĥ�����Ի����Ƴɵ�һ�N�ɓ�ӡˢ�·�壬�����侀�ܶȸߡ������p����ȱ����ɏ������`��ȸߵȃ�(y��u)�c(di��n)��ӭ������Ӯa(ch��n)Ʒ�p�������`��ij���څ�ݡ�
�O����FPC��(ji��n)���ē��o(h��)�ߣ���iPhone��ʹ���˶��_(d��)16ƬFPC����ȫ������FPC��ُ����ȫ��ǰ6��FPC�S����Ҫ�͑������O�������ǡ��A�顢OPPO�ȏS�����O��ʾ����Ҳ�������������ܙC(j��)�е�FPCʹ������
���ܙC(j��)����FPC����Ҫ�ij��L�(q��)�����������������O������ʾ��Ч��(y��ng)�Ď��ӣ�FPC���ٝB��09���ԁ�ÿ�궼�ܱ����^�����٣�15���������PCB�ИI(y��)�H�е����c(di��n)���ɞ�Ψһ��(sh��)�F(xi��n)�����L��Ʒ�
�O�����Ȳ�������ӻ�(li��n)HDI�����I(l��ng)��һ����������������Ӯa(ch��n)Ʒ��С�p���İl(f��)չ�����£��֙C(j��)����Ҳ��(j��ng)�v��“���y(t��ng)���Ӱ�—��ͨHDI—�����HDI”�������^�̡�
��ͨHDI�����@���Ƴ��еęC(j��)е�@ֱ��؞��PCB���c��֮�g�İ�ӣ��������HDI�Լ����@�״�ͨ���c��֮�g���Bͨ�����g�Ļ��Ŀ�ʡ��ʹ���~�����壬�Ķ��a(ch��n)Ʒ�ĺ��׃�ø��p����
����ͨHDI�������HDI�������������O�����I(l��ng)������iPhone 4��iPad 2���״β��������HDI������������ˮa(ch��n)Ʒ���p�����̶ȡ���iPad 2���������iPad 1�������1.34���ֽ����H��0.88���֣���Ҫԭ����Dz�����3+4+3�����HDI�����ͨHDI���O���@һ���g(sh��)����Ѹ���������OꇠI���M(j��n)�������HDI���ٱ��l(f��)���ɞ���һ�������ĸ߶����ܙC(j��)��
ʮ����o(j��)��C(j��)iPhone 8����ʌ�(d��o)����d�壬���_����һ݆�����������(d��ng)ǰ���ܙC(j��)�У��������ܴ��d��Ԫ������(sh��)�����˘O�ޣ�Ҫ�M(j��n)һ���sС�������࣬���Ƴ��������y�Ԍ�(sh��)�F(xi��n)��
��d�壨Substrate-Like PCB�����QSLP����HDI���g(sh��)�Ļ��A(ch��)�ϣ�����M-SAP�Ƴ̣����M(j��n)һ����(x��)����·������һ������(x��)��·ӡ�ư塣�A(y��)Ӌ(j��)�O������ʕ�����ʮ����o(j��)��C(j��)iPhone 8�������d��Č�(d��o)�룬������1ƬHDI�֞�3ƬС�壬��������d���cHDI���ļ��g(sh��)������
�b���O����(chu��ng)���a(ch��n)�I(y��)朵�Ӱ푣������O����FPC�������HDI���������ã����μ��g(sh��)���������_����һ݆�������HDI����d�������������

��һ��M-SAP�Ƴ̷���d�壨SLP��
��d�壨SLP������һ��PCBӲ�壬�Ɍ�����/������HDI��40/40�s�̵�30/30�ס����Ƴ��ρ�������d����ӽ����ڰ댧(d��o)�w���b��IC�d�壬����δ�_(d��)��IC�d���Ҏ(gu��)������;���Ǵ��d���N������Ԫ����������Ԍ���PCB�ķ����������@һȫ�µľ���(x��)��·ӡ�ư�Ʒ��҂������䌧(d��o)�뱳�������칤ˇ�͝��ڹ���(y��ng)�������S���M(j��n)�н��x��
��ʲôҪ��(d��o)����d�壺�O��(x��)����·�B��SIP���b�����ܶ���������
�����֙C(j��)��ƽ����X�Ϳɴ����O(sh��)�����Ӯa(ch��n)Ʒ��С�ͻ��Ͷ�ܻ�����l(f��)չ��Ҫ���d��Ԫ������(sh��)���������Ȼ�����o��·��Ŀ��g�sԽ��Խ���ޡ� ���@�ӵı����£�PCB��(d��o)�����ȡ��g�࣬�ױP��ֱ���Ϳ����ľ��x���Լ���(d��o)�w�Ӻͽ^���ӵĺ�ȶ��ڲ����½����Ķ�ʹPCB�����ڳߴ硢�������w�e�p�p����r�£��������ݼ{�����Ԫ��������ͬĦ������֮�ڰ댧(d��o)�wһ�㣬���ܶ�Ҳ��ӡ�ƾ�·�弼�g(sh��)��֮�Ժ����
-
�O��(x��)����·Ҫ���HDI���ߵ��Ƴ̡����ܶȴ�ʹPCB���༚(x��)����·���a��BGA���g���s�̡�
�ڎ���ǰ��0.6 mm -0.8 mm��(ji��)�༼�g(sh��)�������ˮ�(d��ng)�r���ֳ��O(sh��)���ϣ��@һ�������֙C(j��)������Ԫ��I/O��(sh��)���ͮa(ch��n)ƷС�ͻ���PCB�V��ʹ����0.4 mm��(ji��)�༼�g(sh��)�����@һڅ������0.3 mm�l(f��)չ����(sh��)�ϘI(y��)��(n��i)�������ƄӽK�˵�0.3 mm�g�༼�g(sh��)���_�l(f��)���������_ʼ��ͬ�r���״�С���B�ӱPֱ���ѷքe�½���75 mm��200 mm��
�ИI(y��)��Ŀ��(bi��o)����δ������(n��i)���ͱP�քe�½���50 mm��150mm��0.3mm���g���O(sh��)Ӌ(j��)Ҏ(gu��)��Ҫ������30/30µm���F(xi��n)�е�HDI������Ҫ����Ҫ�����Ƴ̵���d�塣
-
��d�������SIP���b���g(sh��)Ҫ��SIP��ϵ�y(t��ng)�����b���g(sh��)������(j��)���H�댧(d��o)�w·���M����ITRS ���Ķ��x��SIP�錢�������в�ͬ���ܵ���Դ���Ԫ���c���x�oԴ�������Լ��T��MEMS ���߹�W(xu��)����������������(y��u)�ȽM�b��һ�𣬌�(sh��)�F(xi��n)һ�����ܵĆ���(bi��o)��(zh��n)���b�����γ�һ��ϵ�y(t��ng)������ϵ�y(t��ng)�ķ��b���g(sh��)��
��(sh��)�F(xi��n)������C(j��)ϵ�y(t��ng)�Ĺ���ͨ���ЃɷN;����һ�N��SOC���ڸ߶ȼ��ɵĆ�һоƬ�ό�(sh��)�F(xi��n)������C(j��)ϵ�y(t��ng)����һ�N����SIP��ʹ�ó���ĽM�ϻ�(li��n)���g(sh��)��CMOS�ȼ����·�����Ԫ��������һ�����b�w��(n��i)��ͨ�^������оƬ�IJ��ЯB�ӌ�(sh��)�F(xi��n)���C(j��)���ܡ�
��������ڰ댧(d��o)�w�Ƴ̵��������l(f��)���y��SOC�l(f��)չ�������g(sh��)ƿ�i��SIP�ɞ���Ӯa(ch��n)�I(y��)�µļ��g(sh��)�������O����˾��iWatch��iPhone6��iPhone7�Ȯa(ch��n)Ʒ�д���ʹ����SIP���b���A(y��)Ӌ(j��)iPhone 8�������ø����SIP��Q��������(g��u)��SIP���g(sh��)��Ҫ���Ƿ��b�d�w�c�M�b��ˇ������SIP���ԣ�����ϵ�y(t��ng)�����b��(n��i)���߾����ܶȷdz��ߣ���ͨ��PCB���y�Գ��d������d����������ܶ�Ҫ���m������SIP�ķ��b�d�w��

-
��d�匢�����ķN���켼�g(sh��)����ӳɷ�MSAP��Ŀǰ���a(ch��n)����(x��)��·����Ҫ����
Ŀǰ��ӡ�ƾ�·����d�����칤ˇ�У���Ҫ�Мp�ɷ���ȫ�ӳɷ��c��ӳɷ����N��ˇ���g(sh��)��
-
�p�ɷ����p�ɷ���������F(xi��n)��PCB���y(t��ng)��ˇ��Ҳ�Ǒ�(y��ng)���^���������칤ˇ��һ����ù����Կ��g���ρ���ɈD���D(zhu��n)�ƣ�������ԓ���ρ����o(h��)�����g��ȥ���ą^(q��)���S��������Ի�A���g��ˎˮ��δ���o(h��)�^(q��)����~��ȥ����
���ڜp�ɷ���ˇ������ȱ�c(di��n)�����g���^���У���¶�~���������g�̵��^����Ҳ���(c��)���g�̣�����(c��)�g�������ڂ�(c��)�g�Ĵ��ڣ��p�ɷ��ھ���(x��)��·�����еđ�(y��ng)���ܵ��ܴ����ƣ���(d��ng)����/����С��50μm(2mil)�r���p�ɷ����������^���џo����֮�ء�Ŀǰ�p�ɷ���Ҫ�������a(ch��n)��ͨPCB��FPC��HDI��ӡ���·��a(ch��n)Ʒ��
ȫ�ӳɷ���SAP��:ȫ�ӳɷ���ˇ���ú����������Ľ^�����壬�ڰ���·�D���ع��ͨ�^�x���Ի��W(xu��)���~�õ���(d��o)�w�D�Ρ�
ȫ�ӳɷ���ˇ���^�m����������(x��)��·�����������䌦���ġ����W(xu��)���~��������Ҫ���c���y(t��ng)��PCB������������^�ɱ��^���ҹ�ˇ�������죬Ŀǰ�Įa(ch��n)������ȫ�ӳɷ����������a(ch��n)WB��FC�����d�壬���Ƴ̿��_(d��)12μm/12μm��
��ӳɷ���MSAP������ӳɷ���������ο˷��p�ɷ��c�ӳɷ��ھ���(x��)��·�����ϸ��Դ��ڵĆ��}����ӳɷ��ڻ������M(j��n)�л��W(xu��)�~���������γɿ��g�D�Σ���(j��ng)�^�價�ˇ�������ψD�μӺ�ȥ�����g�D�Σ�Ȼ���ٽ�(j��ng)�^�W�g������Ļ��W(xu��)�~��ȥ��������Ĥ���o(h��)�]���M(j��n)���僼Ӻ�ą^(q��)���ڲ���g���^���б��ܿ�ij�ȥ���������IJ����γɾ�·��
MSAP�����c(di��n)�LjD���γ���Ҫ���僺��W�g�����W�g�^���У������g�̵Ļ��W(xu��)�~�ӷdz���������g�̕r�g�dz��̣�����·��(c��)����g�̱��^С���c�p�ɷ���ȣ���·�Č��Ȳ����ܵ����~���Ӱ푣����^�����ƣ����и��ߵĽ����ȣ���������(x��)��·�ľ����;�����һ�£��������߳�Ʒ�ʡ���ӳɷ���Ŀǰ���a(ch��n)����(x��)��·����Ҫ���������a(ch��n)�������_(d��)��С����/����14μm/14μm����С��55μm����������(y��ng)����CSP��WB��FC�����d��Ⱦ���(x��)��·�d������졣
��d���m����ӡ�ƾ�·�壬�����Ƴ́���������С����/������30μm/30μm���o�����Üp�ɷ����a(ch��n)��ͬ����Ҫʹ��MSAP�Ƴ̼��g(sh��)��
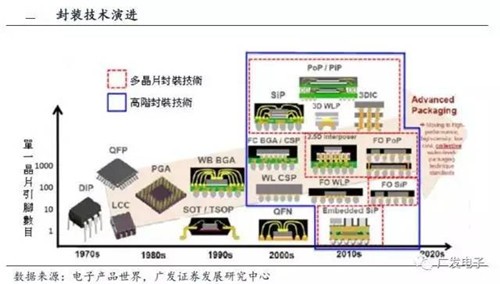
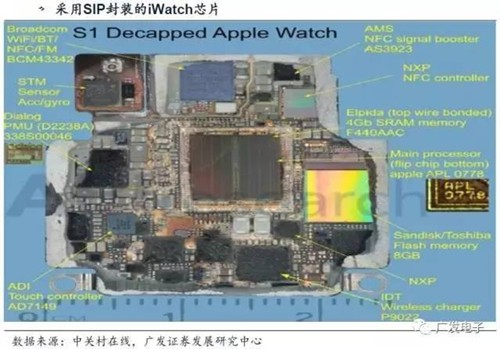
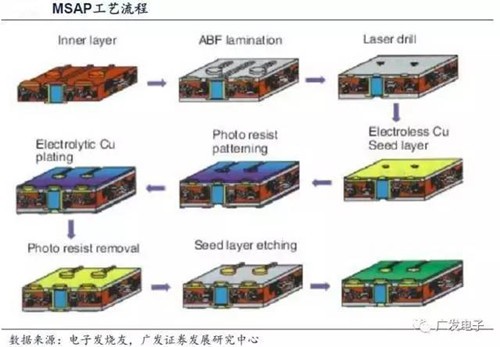
- �I(y��)��(n��i)������Щ���څ��c�ߣ��d��S�����м��g(sh��)��(y��u)�ݣ�HDI�S�̄t���߄���
-
��d�����PCBӲ�壬���Ƴ̄t���ڸ��AHDI��IC�d��֮�g���߶�HDI�S�̺�IC�d��S�̶��ЙC(j��)�����룺
�d��S�����м��g(sh��)��(y��u)�ݣ��P(gu��n)�I����������Ը���d����Ƴ̸�����d�壬�����d��S�̶��ԣ���d���MSAP�Ƴ̼��g(sh��)�^����Ϥ�����d���D(zhu��n)�a(ch��n)��U(ku��)��a(ch��n)��Ͷ����d�岻���ڼ��g(sh��)�ډ������ڮa(ch��n)Ʒ���ʵȷ���ռ��(j��)��(y��u)�ݡ�
Ȼ����d���в����_(d��)���d��ľ���(x��)�ȣ���(y��ng)�����֙C(j��)�����ۃrҲ���ܕ��ܵ����ƣ���(d��o)������ˮƽ�����d��S��ԭ���ĸ߶ˮa(ch��n)Ʒ��ͬ�r��d��Ҳ���ڟo�������ռ����L(f��ng)�U������d��S����Ҫ�м�(x��)��(qu��n)���D(zhu��n)�a(ch��n)��U(ku��)�a(ch��n)�������c�L(f��ng)�U���P(gu��n)�I�����ڼ��g(sh��)��������������Ը�����ڵ��d��S�̅��c�߰������T���Ҿ늵ȡ�
-
HDI�S�̸��߄��������ʌ����P(gu��n)�I���cIC�d����ȣ�HDI�������漤�ң���׃?y��u)�t���Ј����������»����挦��d�厧�������C(j��)��HDI�S��һ����ɽ�˫@������ӆ�Σ���һ����Ɍ�(sh��)�F(xi��n)�a(ch��n)Ʒ��������(y��u)���a(ch��n)Ʒ�M�Ϻ�ӯ��ˮƽ�����������Ը����(qi��ng)�����Ȳ��ֵĄ������㡣
������d����Ƴ̸��ߣ�HDI�S��ҪͶ���Y���������������O(sh��)�䣬MSAP�Ƴ̼��g(sh��)��HDI�S�́��fҲ��Ҫ�W(xu��)��(x��)�r�g���Ĝp�ɷ��D(zhu��n)��MSAP,�a(ch��n)Ʒ���ʌ����P(gu��n)�I�����ڵą��c�߰������d��AT&S���Aͨ���ρ��ȸ߶�HDI�S�̡�
����ӓ��в��d���_���߶ˏS�̵����M(j��n)HDI���켼�g(sh��)�����������PCB������ИI(y��)��(j��ng)�(y��n)���߂��D(zhu��n)����d��PCB�ļ��g(sh��)��(sh��)���������HDI�����^�ɵ���d��PCB��څ�ݵ����������������������һ݆�ļ��g(sh��)������ȡ���șC(j��)�ć���(n��i)�S��֮һ��

-
���^�S�̷e�O�����������³��L�t��
�����O�����a(ch��n)�I(y��)朏�(qi��ng)��Ď������ã�����S�̿�����d��ĝBǰ����������t���������RȦ����ǰ���֣�
���о��T�����S�S���a(ch��n)��d��a(ch��n)Ʒ����˾�Д�������20�|���_�ŵ��Y��֧��������d�匢�ɞ������������L����Ҫ������
���d��ʽ����������d�壬�{(di��o)���Y��֧����2016����ļ���Ͷ�볬�^15�|���_�š��_ʼ�O(sh��)���M(j��n)؛���������ع�C(j��)��僽���Ƴ́�������(x��)������
AT&SͶ�Y1390�f�WԪ���ؑc���O(sh��)���a(ch��n)SLP���S�����Ϻ����Sһ��(g��u)�ɹ�˾��SLP���a(ch��n)�������֣�
�ڸ��AHDI��(x��)��·�۷e���S����(j��ng)�(y��n)���Aͨ��Ҳ�ѷe�O������d��a(ch��n)���������J��Sԇ�a(ch��n)��d�壬Ŀǰ�M(j��n)�����ã��A(y��)Ӌ(j��)�����°��ꌢ�ɴ�����؛��
Ҿ��Ҳ�ڷe�O����SLP���ʣ����Пo��Ը�U(ku��)��a(ch��n)�ܡ�

-
�҂����У���d���������(d��o)�댢��׃�O��PCB����(y��ng)朸�֣�������(y��u)�|(zh��)HDI�S�̌�ӭ��C(j��)�������ǝ��������(bi��o)�ġ�
������d���������ԣ��¼��g(sh��)��Ҏ(gu��)ģͶ�a(ch��n)��Ҫ�r�g���@Щ�����������ֵďS�̮a(ch��n)�ܲ���̫���҂��A(y��)Ӌ(j��)���ɶ�����_���^��I(y��)��ͬ��؛�������S�̶��ڃ�(n��i)�M(j��n)��Ŀ����Բ������_�S���D(zhu��n)����d���HDI����(y��ng)�����F(xi��n)���ڿ�λ����һ��iPhone��ʹ�����T���¼��g(sh��)���龏��Ԫ�����ɱ����������е�HDI����(y��ng)��?q��)���������ꑃ?y��u)�|(zh��)�S���D(zhu��n)�ƣ������S�̵ęC(j��)�����������a(b��)HDI�Ŀ�λ��
�����ܸ��~��u�ɴ����څ
��ӹ��I(y��)�w�ٰl(f��)չ��ͬ�r��Ҳ��������Ӯa(ch��n)Ʒ�U��������(d��o)�µ���Ⱦ���}�����P(gu��n)�о���(sh��)�(y��n)�ѱ����������u�صĻ�������֬������ȼ����늚�a(ch��n)Ʒ������ӡ���·����ģ����ڏU����ķٟ��Е��a(ch��n)���к����|(zh��)��ͬ�r�S��PCB����������L�ֻ�����܇��ӡ�LED�ȿ��ٰl(f��)չ���I(l��ng)��?q��)����~��������������Ҫ�o�u���o�U���� Tg���������D(zhu��n)�Q�ضȣ������l���ߌ�(d��o)��ȸ������طN���~�����������������
-
�h(hu��n)���Ͳ��ϰl(f��)չѸ�͡��S��ȫ��ĭh(hu��n)�����R�X�ѣ��h(hu��n)��������څ��(y��n)������������ѳ��_���P(gu��n)��������Ҏ(gu��)��ӡ�ư��u�ص�ʹ���M(j��n)�����ơ���2008������ԁ����ڇ��H��S�o�u�r�g�����Ƅ��£�����ИI(y��)Ҫ��o�u�ĺ����ӏ�(qi��ng)�ţ��Gɫ��ƽ�M��ÿ���ȶ����Ƴ��µľGɫ������������ᡢ�|֥���Z�������O���ȱ���������C(j��)���^���o�u��ĵ�Ҫ��Ҳ׃��Խ��Խ��(qi��ng)�ҡ���(j��)Prismark�Ĺ��y��2011-2016��o�uFR4���(f��)�����L����ߣ����_(d��)��21.5%���аl(f��)�h(hu��n)�������ѳɞ鮔(d��ng)ǰCCL�ИI(y��)һ�(xi��ng)��Ҫ�Ĺ�����
-
LED���ٰl(f��)չʹ�ߌ�(d��o)�Ḳ�~��ɞ���c(di��n)��С�g��LED���Пoƴ�p���@ʾЧ���á�ʹ�É����L�ȃ�(y��u)�ݣ������_ʼ���l(f��)�B�����L�ܿ죬����(y��ng)��������ĸߌ�(d��o)�Ḳ�~��Ҳ�ɞ���c(di��n)��
-
܇��PCB���a(ch��n)Ʒ�|(zh��)���Ϳɿ���Ҫ��dz���(y��n)������������ܲ��ϸ��~�塣��܇�����PCB��Ҫ�����Α�(y��ng)�á���܇��Ӯa(ch��n)Ʒ���ȱ�횝M����܇����һ����ͨ��������횾߂���������ضȡ����늉����ӡ�늴Ÿɔ_�����ӵ��m��(y��ng)����Ҫ����ߣ��@��܇��PCB�IJ���������ߵ�Ҫ������������ܲ��ϣ����Tg���ϡ���CAF�����sʯ���w�S�����ϡ����~�����Լ��մɲ��ϵȣ����~�塣